Izixhobo zokusika i-infrared Picosecond Dual-Platform Laser Cutting ze-Optical Glass/Quartz/Sapphire Processing
Ipharamitha ephambili
| Uhlobo lweLaser | I-Infrared Picosecond |
| Ubungakanani bePlatform | 700×1200 (mm) |
| 900×1400 (mm) | |
| Ukusika Ubukhulu | 0.03-80 (mm) |
| Isantya sokusika | 0-1000 (mm/s) |
| Ukwaphuka Komphetho Okusikayo | <0.01 (mm) |
| Qaphela: Ubungakanani beplatifomu bungenziwa ngokwezifiso. | |
Ezona mpawu
1. Itekhnoloji yeLaser yeUltrafast:
· Iipulses ezimfutshane zezinga lePicosecond (10⁻¹²s) ezidityaniswe netekhnoloji yokulungisa iMOPA zifikelela kubuninzi bamandla obuphezulu >10¹² W/cm².
· Ububanzi be-infrared (1064nm) bungena kwizinto ezibonakalayo ngokufunxwa okungeyomgca, nto leyo ethintela ukufudunyezwa komphezulu.
· Inkqubo ye-optical egxile kwizinto ezininzi ivelisa iindawo ezine zokucubungula ezizimeleyo ngaxeshanye.
2. Inkqubo yokuvumelanisa yeZitishi ezibini:
· Izigaba zemoto ezizii-motor ezizii-linear ezimbini ezisekelwe kwi-granite (ukuchaneka kokubeka: ± 1μm).
· Ixesha lokutshintsha isikhululo <0.8s, okuvumela imisebenzi "yokucwangcisa-ukulayisha/ukukhulula" ngaxeshanye.
· Ulawulo lobushushu oluzimeleyo (23±0.5°C) ngesitishi ngasinye luqinisekisa uzinzo lwexesha elide lomatshini.
3. Ulawulo lweNkqubo yoBukrelekrele:
· Isiseko sedatha sezinto ezidityanisiweyo (iiparameter zeglasi ezingaphezu kwama-200) zokudibanisa iiparameter ngokuzenzekelayo.
· Ukubeka iliso kwiplasma ngexesha langempela kulungisa amandla elaser ngokuguquguqukayo (isisombululo sohlengahlengiso: 0.1mJ).
· Ukhuseleko lwekhethini lomoya lunciphisa ukuqhekeka okuncinci komphetho (<3μm).
Kwimeko eqhelekileyo yokufaka i-sapphire wafer dicing enobukhulu obuyi-0.5mm, inkqubo ifikelela kwisantya sokusika se-300mm/s kunye nobukhulu be-chipping <10μm, nto leyo ebonisa ukuphuculwa kokusebenza kakuhle okuphindwe kahlanu kuneendlela zemveli.
Iingenelo zokucubungula
1. Inkqubo yokusika kunye nokwahlulahlula izitishi ezimbini ezidibeneyo ukuze isebenze ngokuguquguqukayo;
2. Ukulungiswa kwejiyometri ezintsonkothileyo ngesantya esiphezulu kuphucula ukusebenza kakuhle kokuguqulwa kwenkqubo;
3. Imiphetho yokusika engenamatheli ene-chipping encinci (<50μm) kunye nokuphathwa okukhuselekileyo komqhubi;
4. Utshintsho olungenamthungo phakathi kweenkcukacha zemveliso kunye nokusebenza okubonakalayo;
5.Iindleko zokusebenza eziphantsi, amazinga aphezulu emveliso, inkqubo engenazo izinto ezisetyenzisiweyo kwaye engenazo ungcoliseko;
6. Akukho kuveliswa kwenkunkuma, ulwelo okanye amanzi amdaka aqinisekisiweyo ngomgangatho ofanelekileyo;
Umboniso wesampulu

Izicelo eziqhelekileyo
1. Ukuveliswa kwee-elektroniki zabathengi:
· Ukusikwa kweglasi yesiciko se-3D yefowuni ephathwayo ngokuchanekileyo (ukuchaneka kwe-R-angle: ± 0.01mm).
· Ukubhoboza imingxunya emincinci kwiilensi zewotshi yesafire (ubuncinci bomngxuma: Ø0.3mm).
· Ukugqitywa kweendawo zokudlulisa iglasi ye-optical kwiikhamera ezingaphantsi kwesibonisi.
2. Imveliso yeCandelo le-Optical:
· Umatshini wokulungisa izinto ezincinci kwiilensi ze-AR/VR (ubungakanani beempawu ≥20μm).
· Ukusikwa kweeprism ze-quartz ezigobileyo kwii-laser collimators (ukunyamezelana kwe-angular: ±15").
· Ukuyila iprofayili yezihluzi ze-infrared (i-cutting taper <0.5°).
3. Ukupakisha i-semiconductor:
· Ukulungiswa kweglasi ngokusebenzisa (TGV) kwinqanaba le-wafer (umlinganiselo womphezulu yi-1:10).
· Ukukrola imijelo emincinci kwi-substrates zeglasi zeetships ze-microfluidic (Ra <0.1μm).
· Ukunciphisa rhoqo ii-resonators ze-quartz ze-MEMS.
Kwimveliso yeefestile ze-optical ze-LiDAR zeemoto, le nkqubo ivumela ukusika iglasi ye-quartz enobukhulu obuyi-2mm kunye nokuma okuthe nkqo kwe-89.5±0.3°, okwanelisa iimfuno zovavanyo lokungcangcazela lwe-automotive-grade.
Izicelo zeNkqubo
Yenzelwe ngokukodwa ukusika ngokuchanekileyo izinto ezibuthathaka/eziqinileyo kuquka:
1. Iiglasi eziqhelekileyo kunye neeglasi ezibonakalayo (BK7, i-fused silica);
2. Iikristale zeQuartz kunye nesubstrates zesafire;
3. Izihluzi zeglasi ezithambileyo kunye nezibonakalayo
4. Izinto ezisetyenziswa kwisipili
Iyakwazi ukusika i-contour kunye nokubhola imingxunya yangaphakathi ngokuchanekileyo (ubuncinci Ø0.3mm)
Umgaqo wokusika ngeLaser
I-laser ivelisa ii-pulses ezimfutshane kakhulu ezinamandla aphezulu kakhulu asebenzisana nomsebenzi ngaphakathi kwe-femtosecond-to-picosecond timescales. Ngexesha lokusasazeka kwezinto, umqadi uphazamisa isakhiwo sawo soxinzelelo ukuze wenze imingxunya ye-filamentation ye-micron-scale. Ukwahlulwa kwemingxuma okwenziwe ngcono kuvelisa ii-micro-cracks ezilawulwayo, ezidityaniswa netekhnoloji yokuqhekeka ukuze kufezekiswe ukwahlukana ngokuchanekileyo.
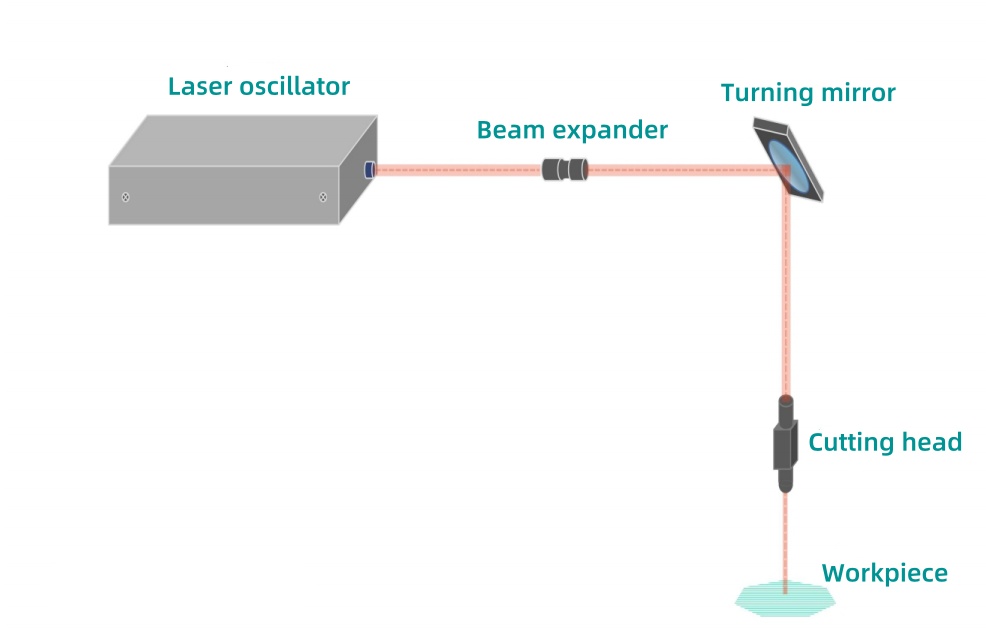
Iingenelo zokusika iLaser
1.Ukuhlanganiswa okuphezulu kwe-automation (ukusebenza okudibeneyo kokusika/ukuqhekeza) kunye nokusetyenziswa kwamandla aphantsi kunye nokusebenza okulula;
2. Ukucubungula okungaqhagamshelaniyo kwenza ukuba izakhono ezikhethekileyo zingafumaneki ngeendlela eziqhelekileyo;
3. Ukusebenza ngaphandle kokusetyenziswa kunciphisa iindleko zokusebenza kwaye kuphucula uzinzo lokusingqongileyo;
4. Ukuchaneka okuphezulu kakhulu nge-engile ye-taper ye-zero kunye nokususwa komonakalo we-workpiece yesibini;
I-XKH inikezela ngeenkonzo ezibanzi zokwenza ngokwezifiso iinkqubo zethu zokusika i-laser, kubandakanya uqwalaselo lweqonga elenziwe ngokwezifiso, uphuhliso lweeparameter zenkqubo ezikhethekileyo, kunye nezisombululo ezithile zesicelo ukuhlangabezana neemfuno zemveliso ezizodwa kumashishini ahlukeneyo.




